
來源:科技全掌握
如今,構(gòu)建高性能微處理器變得越來越棘手,成本也越來越高,這就是為什么開發(fā)人員必須選擇復(fù)雜的封裝技術(shù)以及針對性能要求高的應(yīng)用程序的設(shè)計。蘋果承認(rèn),要制造其 M1 Ultra 處理器,它必須將兩個 M1 Max 系統(tǒng)級芯片融合在一起,但它沒有說它必須使用臺積電最先進(jìn)的封裝技術(shù)之一來制造 M1 Ultra。
幸運的是,非官方消息來源沒有蘋果那么神秘,并且能夠挖掘出有關(guān)蘋果 UltraFusion 處理器間互連的更多細(xì)節(jié),該處理器提供 2.5 TB/s 的帶寬。 有媒體報道稱,Apple 的 M1 Ultra 處理器使用TSMC的CoWoS-S(帶有硅中介層的芯片上晶圓基板)基于2.5D中介層的封裝工藝來構(gòu)建M1 Ultra。AMD、Nvidia和富士通等公司使用類似的技術(shù)來構(gòu)建用于數(shù)據(jù)中心和高性能計算 (HPC) 的高性能處理器。
Apple 的 M1 Ultra 無疑是一個強(qiáng)大的設(shè)計。每個M1 Max SoC 的裸片尺寸為432mm²,因此M1Ultra使用的中介層必須超過860mm²。這是相當(dāng)大的,但并非聞所未聞。AMD 和 Nvidia 使用更大的中介層,其計算 GPU 具有高帶寬內(nèi)存。
我們不知道如何稱呼 M1 Ultra。從技術(shù)上講,這是一個系統(tǒng)級芯片封裝,或 SoC IP,但這可能有點拗口,所以我們現(xiàn)在稱它為“處理器”。
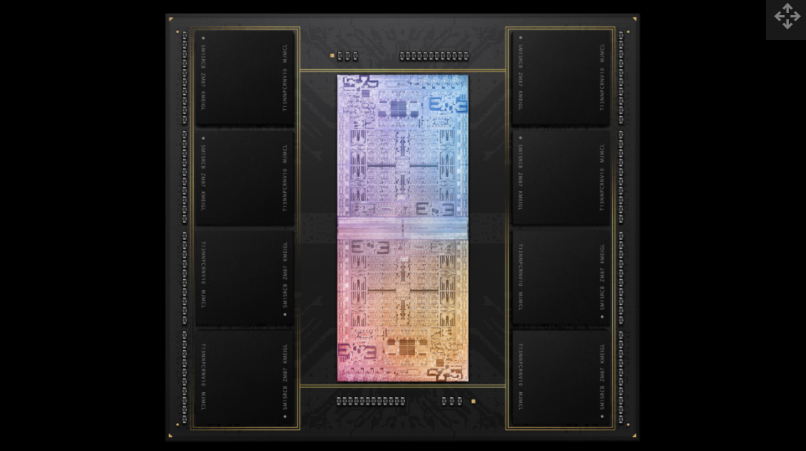
但臺積電的CoWoS-S并不是這家全球最大的半導(dǎo)體制造商在帶寬密集型應(yīng)用中的唯一選擇。一些專家推測,蘋果可能會選擇臺積電的InFO_LSI技術(shù)進(jìn)行超高帶寬小芯片集成。與 CoWoS-S不同,InFO_LSI使用局部硅互連而不是大型且昂貴的中介層。英特爾的嵌入式芯片互連橋(EMIB) 使用相同的概念。
請記住,Apple 展示了帶有大型 I/O 焊盤的 M1 Max die shot,類似于旨在連接到中間芯片的本地互連,因此許多人認(rèn)為Apple 使用了 InFO_LSI 也就不足為奇了。
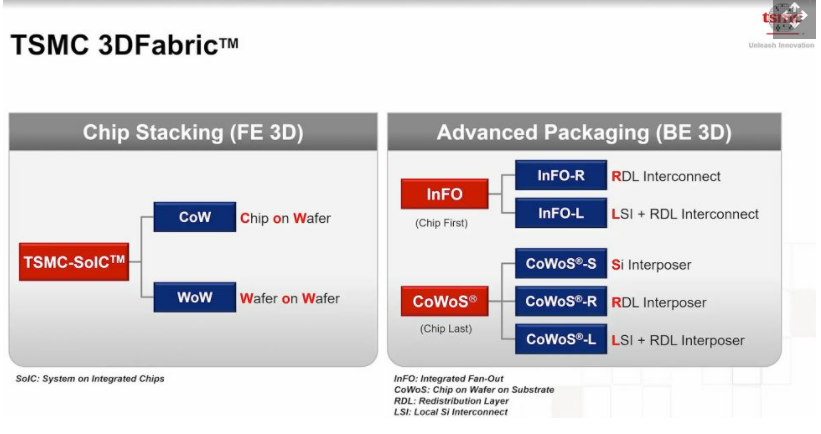
但蘋果可能堅持使用可能更昂貴的 CoWoS-S 是有原因的。臺積電的 InFO_LSI 于 2020 年 8月正式推出,原定于 2021 年 Q1 完成認(rèn)證。與此同時,Apple 的 M1 Max 將于2021 年 Q2 或 Q3 進(jìn)入量產(chǎn),因此蘋果可能根本沒有足夠的時間實現(xiàn) InFO_LSI。或者它決定不冒險并堅持使用各種公司廣泛使用的知名技術(shù)。
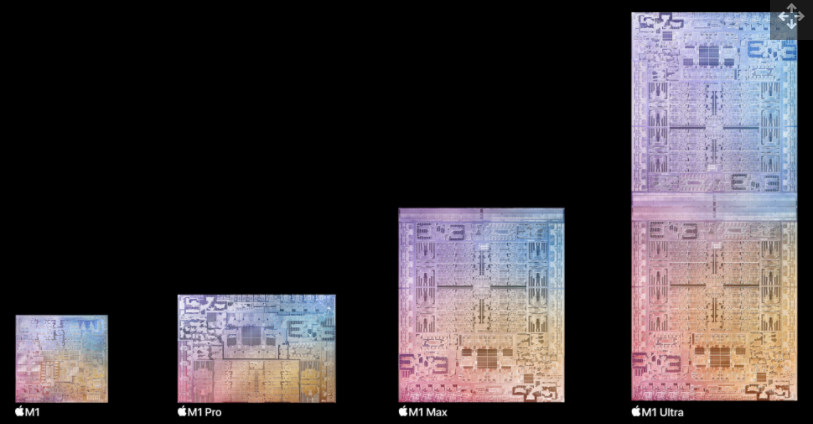
DigiTimes披露的另一 件事是,Unimicron Technology現(xiàn)在是蘋果唯一的ABF基板供應(yīng)商,因為它是唯一一家能夠提供蘋果需要的質(zhì)量和數(shù)量的公司。無論如何,雖然我們現(xiàn)在知道 Apple 使用什么封裝技術(shù)來實現(xiàn)其 UltraFusion 互連,但我們?nèi)匀徊恢浪臅r鐘、總線寬度、功率等,所以請繼續(xù)關(guān)注。






