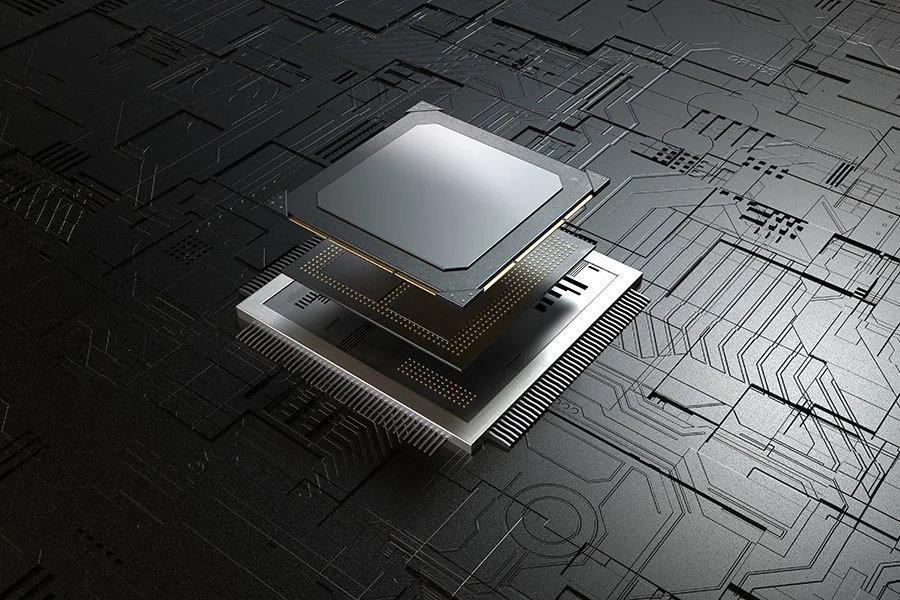
據(jù)TheElec報(bào)道,英偉達(dá)正在努力實(shí)現(xiàn)數(shù)據(jù)中心AI GPU中使用的HBM3和2.5D封裝的采購(gòu)多元化。
消息人士稱,這家美國(guó)芯片巨頭正在與包括三星在內(nèi)的潛在供應(yīng)商進(jìn)行交易談判。
目前,英偉達(dá)的A100、H100和其他AI GPU均使用臺(tái)積電進(jìn)行晶圓制造和2.5封裝工作的前端工藝。英偉達(dá)AI GPU使用的HBM(高帶寬內(nèi)存)芯片由SK海力士獨(dú)家提供。然而,臺(tái)積電沒有能力處理這些芯片所需的2.5D封裝的所有工作量。
消息人士稱,英偉達(dá)正在與二級(jí)和替代供應(yīng)商就數(shù)量和價(jià)格進(jìn)行談判,其中包括Amkor Technology(安靠科技)和SPIL(矽品精密工業(yè))。SK海力士將繼續(xù)供應(yīng)所使用的HMB3。
三星的先進(jìn)封裝團(tuán)隊(duì)(AVP)是另外的潛在供應(yīng)商,該團(tuán)隊(duì)由三星電子去年底成立,旨在擴(kuò)大芯片封裝收入。
AVP團(tuán)隊(duì)可以接收英偉達(dá)從臺(tái)積電采購(gòu)的AI GPU晶圓,然后從三星存儲(chǔ)芯片業(yè)務(wù)部門采購(gòu)HBM3,并使用自己的I-Cube 2.5D封裝來完成工作。
三星向英偉達(dá)提出了這一提議,同時(shí)還補(bǔ)充說,它可以派遣大量工程師參與該項(xiàng)目。三星還提出為英偉達(dá)設(shè)計(jì)中介層晶圓。
消息人士稱,如果這筆交易通過,三星預(yù)計(jì)將處理英偉達(dá)約10%的AI GPU封裝量。
不過,他們補(bǔ)充說,三星必須滿足英偉達(dá)的要求,并通過其HBM3和2.5D封裝的質(zhì)量測(cè)試。
三星計(jì)劃于今年晚些時(shí)候開始生產(chǎn)HBM3。7月早些時(shí)候,三星半導(dǎo)體負(fù)責(zé)人Kyung Kye-hyun通過公司內(nèi)部聊天工具分享稱,該公司的HBM3被客戶評(píng)價(jià)為優(yōu)秀。Kyung Kye-hyun表示,他預(yù)計(jì)HBM3和HBM3P將從明年開始為芯片部門的利潤(rùn)增長(zhǎng)做出貢獻(xiàn)。
與此同時(shí),臺(tái)積電還計(jì)劃將其2.5D封裝產(chǎn)能擴(kuò)大40%以上,以滿足英偉達(dá)不斷增長(zhǎng)的需求。
這意味著三星除非迅速通過英偉達(dá)的評(píng)估,否則可能無法達(dá)成交易。
三星還致力于到2025年開發(fā)無凸點(diǎn)封裝,該封裝針對(duì)高層HBM,有助于降低封裝高度,該技術(shù)也稱為銅-銅直接鍵合或混合鍵合(Cu-Cu Hybrid Bonding)。
【來源:集微網(wǎng)】






